Kính hiển vi điện tử quét – Wikipedia tiếng Việt
Kính hiển vi điện tử quét (tiếng Anh: Scanning Electron Microscope, thường viết tắt là SEM), là một loại kính hiển vi điện tử có thể tạo ra ảnh với độ phân giải cao của bề mặt mẫu vật bằng cách sử dụng một chùm điện tử (chùm các electron) hẹp quét trên bề mặt mẫu. Việc tạo ảnh của mẫu vật được thực hiện thông qua việc ghi nhận và phân tích các bức xạ phát ra từ tương tác của chùm điện tử với bề mặt mẫu vật.
Mục Lục
Lược sử về kính hiển vi điện tử quét[sửa|sửa mã nguồn]
Kính hiển vi điện tử quét lần tiên phong được tăng trưởng bởi Zworykin vào năm 1942 là một thiết bị gồm một súng phóng điện tử theo chiều từ dưới lên, ba thấu kính tĩnh điện và mạng lưới hệ thống những cuộn quét điện từ đặt giữa thấu kính thứ hai và thứ ba, và ghi nhận chùm điện tử thứ cấp bằng một ống nhân quang điện .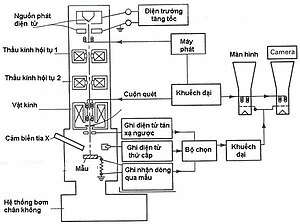
Năm 1948, C. W. Oatley ở Đại học Cambridge (Vương quốc Anh) phát triển kính hiển vi điện tử quét trên mô hình này và công bố trong luận án tiến sĩ của D. McMullan với chùm điện tử hẹp có độ phân giải đến 500 Angstrom. Trên thực tế, kính hiển vi điện tử quét thương phẩm đầu tiên được sản xuất vào năm 1965 bởi Cambridge Scientific Instruments Mark I.
Bạn đang đọc: Kính hiển vi điện tử quét – Wikipedia tiếng Việt
Nguyên lý hoạt động giải trí và sự tạo ảnh trong SEM[sửa|sửa mã nguồn]
Việc phát các chùm điện tử trong SEM cũng giống như việc tạo ra chùm điện tử trong kính hiển vi điện tử truyền qua, tức là điện tử được phát ra từ súng phóng điện tử (có thể là phát xạ nhiệt, hay phát xạ trường…), sau đó được tăng tốc. Tuy nhiên, thế tăng tốc của SEM thường chỉ từ 10 kV đến 50 kV vì sự hạn chế của thấu kính từ, việc hội tụ các chùm điện tử có bước sóng quá nhỏ vào một điểm kích thước nhỏ sẽ rất khó khăn. Điện tử được phát ra, tăng tốc và hội tụ thành một chùm điện tử hẹp (cỡ vài trăm Angstrong đến vài nanomet) nhờ hệ thống thấu kính từ, sau đó quét trên bề mặt mẫu nhờ các cuộn quét tĩnh điện. Độ phân giải của SEM được xác định từ kích thước chùm điện tử hội tụ, mà kích thước của chùm điện tử này bị hạn chế bởi quang sai, chính vì thế mà SEM không thể đạt được độ phân giải tốt như TEM. Ngoài ra, độ phân giải của SEM còn phụ thuộc vào tương tác giữa vật liệu tại bề mặt mẫu vật và điện tử.
Khi điện tử tương tác với bề mặt mẫu vật, sẽ có các bức xạ phát ra, sự tạo ảnh trong SEM và các phép phân tích được thực hiện thông qua việc phân tích các bức xạ này. Các bức xạ chủ yếu gồm:
- Điện tử thứ cấp (Secondary electrons): Đây là chế độ ghi ảnh thông dụng nhất của kính hiển vi điện tử quét, chùm điện tử thứ cấp có năng lượng thấp (thường nhỏ hơn 50 eV) được ghi nhận bằng ống nhân quang nhấp nháy. Vì chúng có năng lượng thấp nên chủ yếu là các điện tử phát ra từ bề mặt mẫu với độ sâu chỉ vài nanomet, do vậy chúng tạo ra ảnh hai chiều của bề mặt mẫu.
- Điện tử tán xạ ngược (Backscattered electrons): Điện tử tán xạ ngược là chùm điện tử ban đầu khi tương tác với bề mặt mẫu bị bật ngược trở lại, do đó chúng thường có năng lượng cao. Sự tán xạ này phụ thuộc rất nhiều vào thành phần hóa học ở bề mặt mẫu, do đó ảnh điện tử tán xạ ngược rất hữu ích cho phân tích về độ tương phản thành phần hóa học. Ngoài ra, điện tử tán xạ ngược có thể dùng để ghi nhận ảnh nhiễu xạ điện tử tán xạ ngược, giúp cho việc phân tích cấu trúc tinh thể (chế độ phân cực điện tử). Ngoài ra, điện tử tán xạ ngược phụ thuộc vào các liên kết điện tại bề mặt mẫu nên có thể đem lại thông tin về các đômen sắt điện.
Một số phép nghiên cứu và phân tích trong SEM[sửa|sửa mã nguồn]
Ưu điểm của kính hiển vi điện tử quét[sửa|sửa mã nguồn]
Mặc dù không hề có độ phân giải tốt như kính hiển vi điện tử truyền qua nhưng kính hiển vi điện tử quét lại có điểm mạnh là nghiên cứu và phân tích mà không cần hủy hoại vật mẫu và hoàn toàn có thể hoạt động giải trí ở chân không thấp. Một điểm mạnh khác của SEM là những thao tác tinh chỉnh và điều khiển đơn thuần hơn rất nhiều so với TEM khiến cho nó rất dễ sử dụng. Một điều khác là giá tiền của SEM thấp hơn rất nhiều so với TEM, vì vậy SEM phổ cập hơn rất nhiều so với TEM .
Một số ảnh chụp bằng SEM[sửa|sửa mã nguồn]
Liên kết ngoài[sửa|sửa mã nguồn]
- Joseph Goldstein, Dale E. Newbury, David C. Joy, Charles E. Lyman, Patrick Echlin, Eric Lifshin, L.C. Sawyer, J.R. Michael (2003). Scanning Electron Microscopy and X-ray Microanalysis. Springer; 3rd ed. ISBN-13 978-0306472923.
Source: https://dvn.com.vn
Category: Điện Tử







